Process:
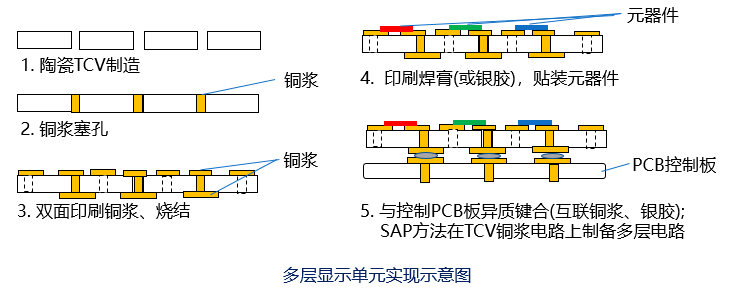
Process Features:
• Wide depth-to-diameter ratio, good slurry fluidity, complete hole wall adhesion
• Dry process , avoid residues caused by copper chemistry
• High process efficiency, completely filling all holes with only printing
• High reliability , adjustable coefficient of thermal expansion
• High efficiency, good quality and low cost of vacuum plug hole
• The resistivity is close to pure copper to achieve effective conduction of large currents
• Low coefficient of thermal expansion of hole copper and interface layer for high reliability
Process Advantages:
· The dielectric coefficient is small, the high frequency characteristics are good, and the signal delay time can be reduced
· The coefficient of thermal expansion is closer to that of silicon, and the coefficient of thermal expansion of inorganic substrate materials is generally lower than that of organic substrate materials
· Strong heat resistance, the glass transition temperature of inorganic substrate materials is generally higher than that of organic substrate materials, and it is not easy to be damaged during thermal shock and thermal cycling
· High thermal conductivity, which can discharge the heat generated by highly integrated packaging in time
· High mechanical strength, good dimensional stability, so that the installation accuracy of components is high
· Strong chemical stability, can resist the erosion of acids, alkalis and organic solvents during processing, and does not produce changes in characteristics such as discoloration and swelling
· Good insulation performance and high reliability
Processing Capacity:
Substrate | alumina | Aluminum nitride |
Coefficient of Thermal Expansion | 6.8 ppm/K | 4.7 ppm/K |
Thermal Conductivity | 23 w/m·k | 170 w/m·k |
Size | <182X182mm | <120X120mm |
Thickness | 0.25∽1mm | 0.15mm∽0.63mm |
Aperture | >60μm | >60μm |
Depth-to-diameter Ratio | <10:1 | <10:1 |
Hole Margins | >0.1mm | >0.1mm |
Application:
· High-power power electronic modules, solar panel components, etc
· High-frequency switching power supply, solid state relay
· Automotive electronics, laser, CMOS image sensors
· High-power LED lighting products
· Communication antennas, car igniters
Processing Effect: