By developing a plug hole copper paste with high conductivity, BAI SOFT scrapes the conductive copper paste into the through-silicon via by scraper pressure, so as to realize the metallization of through-silicon hole TSV with high thickness to diameter ratio, and can process 25-150um through-silicon hole TSV through-hole metallization. /b15>Provide through-silicon vias TSV via metallization foundry services for semiconductor package carrier board customers. Plug hole copper paste can also be customized and supplied for customers to achieve through-silicon hole TSV metallization full filling. TSV after passing through the copper paste plug hole can make the chip stack in a three-dimensional direction, reduce the interconnection length through vertical interconnection, reduce the signal delay, reduce the capacitance and inductance of the chip, realize low-power and high-speed communication between chips, increase broadband and realize the miniaturization of device integration, which is recognized as the fourth generation of package interconnection technology.
Process:
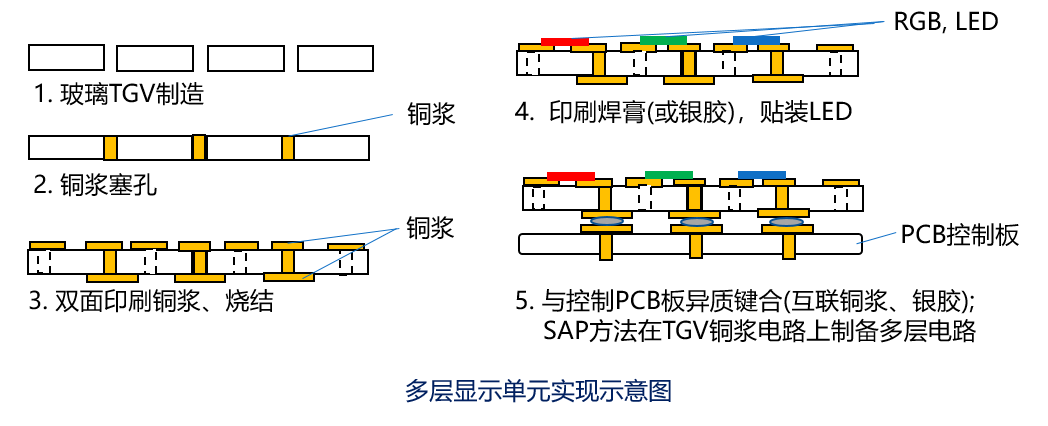
Technology Advantages:
· The low equipment investment reduces the traditional sputtering and electroplating large-scale equipment and capital investment
· The process is simple, and the metal paste such as copper paste is metallized and filled with through-silicon hole TSV by mold and physical pressure
· The adhesion is good, and the through-silicon hole TSV metal paste contains glass powder, which improves the adhesion between the metal paste and the silicon substrate
· Through-silicon hole TSV metallization with high thickness-to-diameter ratio can be realized, and the maximum plug hole thickness to diameter ratio is as high as 20:1
· The process is simple, only+ printing + sintering + grinding three steps can be realized
Technology Reliability:
· Chemical resistance, thermal stress resistance, good weldability
· Stable post-process reliability, etching, surface treatment
· Low roughness: Ra<0.5μm
· High adhesion: >3N/mm
· Thermal shock below 300°C, stable adhesion
· 1000 thermal cycles with stable adhesion
Technology Capability:

Application :
TSV is a high-density packaging technology, which is gradually replacing the current relatively mature wire bonding technology and is considered to be the fourth generation packaging technology. TSV technology can reduce interconnect length, reduce signal delay, reduce capacitance/inductance, achieve low power consumption between chips, high-speed communication, increase bandwidth, and realize miniaturization of device integration through vertical interconnect. It is widely used in the field of three-dimensional packaging of RF , storage, communication and other chips. In through-silicon vias, the plug-hole copper paste of TGV can be heterogeneously interconnected with metals such as package substrates or PCB boards, enabling multidimensional packaging.
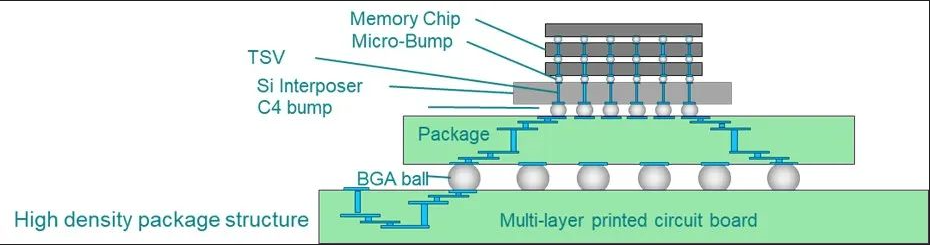
Processing Performance: